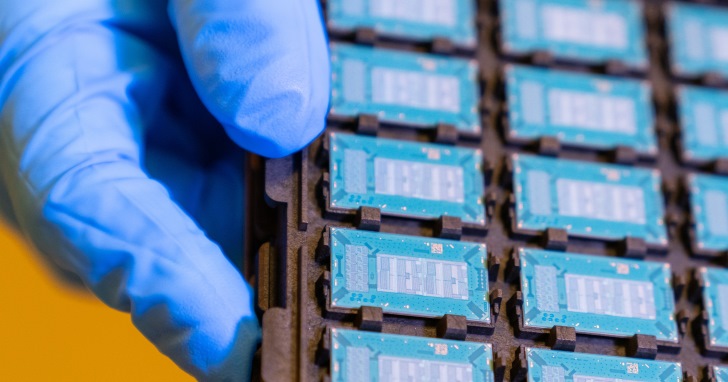
ADVERTISEMENT
Intel展示領先業界的玻璃基板先進封裝技術,克服目前有機材料的局限,藉由提升晶片效能並滿足未來數據中心和人工智慧相關產品的需求。
玻璃材料開花結果
Intel包裝與測試發展(Assembly and Test Development)資深副總裁暨總經理Babak Sabi表示,Intel經歷10年的研究以發展出領先業界的玻璃基板先進封裝技術,並期待自家與晶片代工客戶的產品能夠享受這些尖端技術帶來的優勢。
與現今使用的有機材料基板相比,玻璃基板能夠有更高的平整度,包含熱脹冷縮在內的等機械特性與穩定性也都更加理想,有助於提高基板中的互連密度更高,進而達到讓晶片架構師能針對AI運算等資料密集型工作負載設計更高密度、高效能的晶片。
Intel也預測到2020年代(指2020~2030年之間)結束之前,半導體製程可能就會遇到在有機材料基板上微縮電晶體尺寸的極限,並面臨功耗以及基板收縮和翹曲等機械方面的問題,因此改用玻璃機板將會成為次世代半導體製程中重要的關鍵因素。Intel預估將在2020年代後半(Second of this decade)推出完整的玻璃基板解決方案,並在2030年之後繼續推進摩爾定律。






改善晶片的特性
Intel表示玻璃材質基板具有理想的機械、物理和光學特性,可以在單一封裝中容納更多的電晶體,並提供更具彈性的擴展性,與當今使用的有機材質基板相比,能夠容納尺寸更大的小晶片(Chiplet)與模塊(Tile),進而提升系統級封裝(System-in-Package)的效能與功能,並降低功耗。
玻璃材質基板能夠承受更高的溫度,能夠降低50%圖案變形(Pattern Distortion)狀況,同時更高的平整度有助於改善生產過程微影的焦距深度(Depth of Focus),此外也能無痕導入光學晶片間互連裝置(Seamlessly Integrate Optical Interconnects),並可在更高溫的加工環境下嵌入電感與電容,有助於改善電力傳輸解決方案,並降低高速信號傳輸的功耗,有望讓整體互連密度提升10倍,同時也能有效提高超大型封裝的良率
玻璃材質基板初期將導入數據中心、AI、繪圖等需要更大尺寸封裝與更高通訊速度的應用與產品。



Intel透過PowerVia與RibbonFET以及玻璃材質基板封裝等技術,不斷推進半導體產業的發展,並致力運用這些技術,在2030年完成在單一封裝內納入1兆個電晶體的里程碑
請注意!留言要自負法律責任,相關案例層出不窮,請慎重發文!