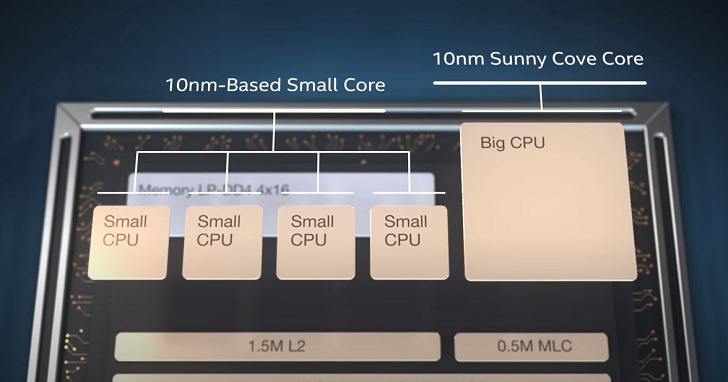
在 ARM 處理器上普遍使用的大小核架構,現在 Intel 終於也跟上了腳步。全新推出的 3D 堆疊 Lakefield CPU,將有 1 個 Sunny Cove 大核心配合 4 個低功耗 Tremont 核心共同運作,未來預計應用於行動裝置甚至筆記型電腦上。
經歷數個月預告,Intel 終於在今天正式為市場帶來全新的 3D 堆疊 Lakefield 處理器,將來可為硬體製造商提供更加小巧,但功能卻更為廣泛的晶片組選項,無論應用於可摺疊式裝置或雙螢幕設備,Lakefield CPU 都直指 ARM 市場而來。
全新 3D 堆疊 Lakefield 處理器融合了 Intel 的兩大技術「混合核心」與「Foveros 3D 堆疊封裝」。
目前確定會採用此 CPU 的產品共有三款,分別是 Intel 處理器版本的長時連網筆電 Galaxy Book S,可摺疊的 Lenovo ThinkPad X1 Fold,以及搭載雙螢幕的微軟 Surface Neo。值得注意的是,Galaxy Book S 還擁有高通 Snapdragon 8cx 的 ARM 版本。

Intel 的「混合核心」技術允許 Lakefield 處理器在單個 Die 上,將一個 10 奈米製程 Sunny Cove CPU 當成主力運算大核心,配合四個低功耗且同樣 10 奈米製程 Atom 等級的 Tremont 小核心,組成共 5 核心 5 執行緒的處理器進行運作。
Lakefield 處理器如此配置的好處在於,能夠兼顧運算效能跟電池續航力之間的平衡,這正是目前行動裝置最主要的需求。

當然,Lakefield 處理器的組成概念跟 ARM 的 Big.Little 架構十分類似,無論高通的 Snapdragon、三星的 Exynos 或華為的 Kirin,也都靠 Big.Little 架構獲得了成功。這代表未來 Lakefield 處理器主打的市場,同樣為手機、平板電腦等行動裝置,甚至於高效能長時連網筆記型電腦。
至於 Lakefield 處理器的另一項重大創新,莫過於 Intel 寄予厚望的「Foveros 3D 堆疊封裝」。

Lakefield 內部分為三層,其中兩層除了運算核心外,還包入了 Intel UHD GPU 顯示晶片跟 I/O 控制器,至於第三層則是 DRAM,更緊湊的配置有效減少空間浪費。Intel 指出,若與 Intel Core-i7 8500Y 處理器相比,新的 Lakefield CPU 將封裝面積縮小了 56%,電路板尺寸縮小了 47%。
初代 Lakefield 處理器產品預計將有兩款型號,分別是 Core i5-L16G7 和 Core i3-L13G4,TDP 都僅僅只有 7W,並具備 Gen11 GPU 與 Wi-Fi 6 支援。
Intel Core i5-L16G7 擁有 1.4 GHz 基礎時脈,Turbo Boost 可達單核心 3.0 GHz 與全核心 1.8 GHz。至於 Intel Core i3-L13G4 的基礎時脈為 0.8 GHz,單核心 Turbo Boost 可達 2.8GHz,全核心加速則是 1.3GHz。
來源:The Verge
想看小編精選的3C科技情報&實用評測文,快來加入《T客邦》LINE@
請注意!留言要自負法律責任,相關案例層出不窮,請慎重發文!