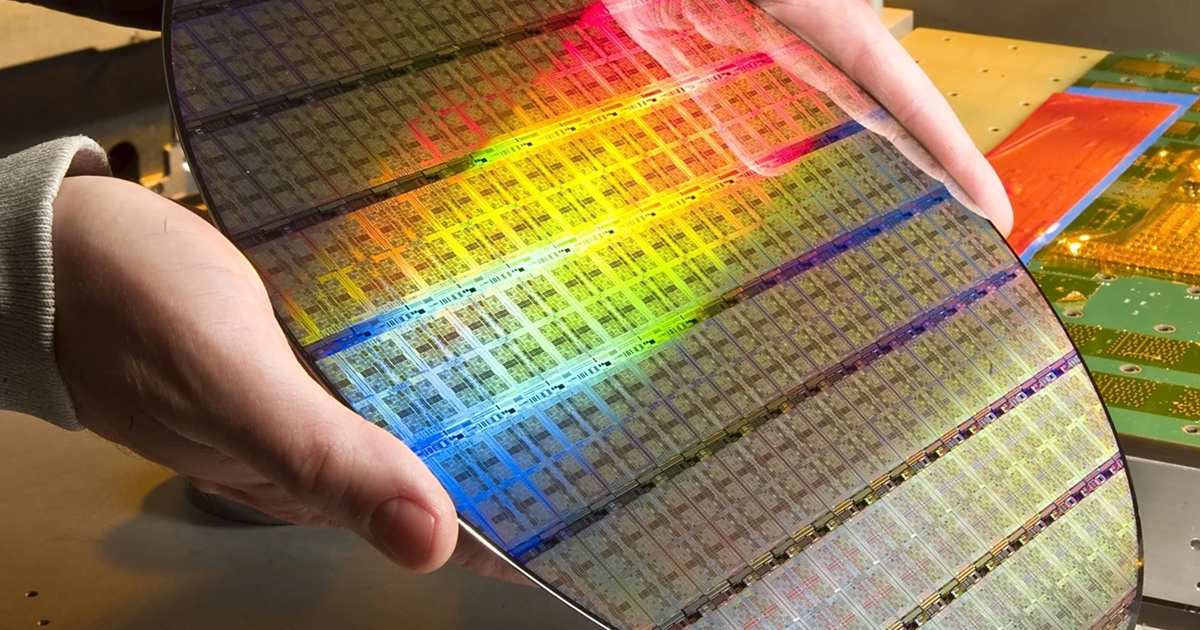
專注於高階半導體製程中「隨機性誤差」(stochastics)量測與控制技術的Fractilia,在最新發表的白皮書中指出,若無法有效控制這些隨機性圖案變異,將大幅拖慢量產進度並導致良率下降,每座晶圓廠恐怕因此損失高達數億美元,累計影響甚至達數十億美元規模。
Fractilia表示,這些源自於微影製程中材料、光源、設備等隨機因素所造成的變異,已經成為阻礙先進製程(如極紫外光EUV或高數值孔徑EUV)進入高量產階段的最大挑戰。傳統製程控制手法難以應對這種不可預測的誤差,Fractilia則提出以「機率分析」、「精準量測」以及「具隨機性思維」的設計方法做為解決之道。
Fractilia技術長Chris Mack表示:「目前的隨機性變異使得原本在研發階段能成功製作的結構,到了量產階段卻無法維持預期良率與穩定性,導致效能和可靠度都無法達標。產業若不採取新的處理方式,未來的晶片製造將會陷入瓶頸。」
他指出,Fractilia觀察到客戶在研發階段可成功製作出僅12奈米的高密度圖案,但一旦進入生產階段,隨機性誤差就開始影響成品的良率與穩定性。
過去由於製程解析度限制,隨機性問題對良率的實際影響有限。然而,隨著製程技術突破極限,微影解析度提升,這些原本可以忽略的隨機性效應,如今在誤差容許範圍中占比迅速提高,成為生產端的一大風險。
Fractilia的白皮書是業界首次從解析度的角度深入探討這些隨機性效應,並指出所謂「隨機性落差」的問題:也就是研發階段與量產階段之間,在結構尺寸控制上出現的誤差斷層。這些誤差並非來自操作失誤,而是製程本身的物理限制所造成。
Mack強調:「這不是單一公司的問題,而是整個產業都得共同面對的挑戰。好消息是,我們已經看到方法與技術能夠縮短這個落差,只要從正確的量測出發,並導入更有效的設計與製程策略,就有機會解決這個問題。」
Fractilia表示,目前已在其官網公開白皮書全文,裡面詳細整理了對應解方,包括如何透過材料選擇、設計思維、製程優化,全面應對這種新的製造挑戰。
- 延伸閱讀:AI晶片需求旺盛!輝達市值突破4兆美元,黃仁勳成全球十大富豪
- 延伸閱讀:蘋果、Google猛將齊聚!英特爾組AI晶片「復仇者聯盟」力拼NVIDIA
- 延伸閱讀:蘋果高層回顧自研Apple Silicon晶片歷程,表示是場豪賭「我們沒有Plan B 」

請注意!留言要自負法律責任,相關案例層出不窮,請慎重發文!